【導讀】在先進封裝技術向高集成度、高功率密度演進的過程中,熱界面材料(TIM)正經歷著從單純導熱填充物到核心結構【導讀】功能層的深刻變革。面對芯片、基板與模封材料間熱膨脹系數差異引發的翹曲、分層及可靠性挑戰,傳統單層連續TIM架構已難以滿足需求。本文深入探討了以臺積電為代表的行業前沿如何通過分區多TIM架構、復合材料創新以及三維熱路徑重構,將熱管理與機械應力調控深度融合。這些技術突破不僅解決了高熱流密度下的散熱瓶頸,更通過材料與微結構的協同優化,為提升先進封裝的良率與長期可靠性提供了關鍵解決方案。
1.熱界面材料(TIM):從配角到核心角色
在先進封裝體系中,TIM 是將熱量從芯片傳導至蓋板和散熱器的關鍵媒介。如今,它已不再只是簡單的導熱填充物,而是同時承擔熱設計與機械調控功能的重要結構層。其表現直接影響封裝翹曲、界面分層、金屬間化合物生成、共面性以及長期可靠性。
從單層 TIM 到分區、多 TIM 架構
在大型高端封裝中,芯片、基板、模封材料和蓋板之間存在明顯的熱膨脹系數差異。熱循環過程中,這種差異不可避免地導致封裝翹曲,而應力往往集中在 TIM 層的邊角或附著力較弱的區域,增加開裂和分層風險。隨著封裝尺寸和功率密度持續攀升,熱—機械耦合問題已成為影響良率與壽命的核心挑戰。
為此,臺積電提出將傳統連續單層 TIM 拆分為多個功能區,或在 TIM 中設計溝槽結構,使應力能夠在局部釋放,而不是在整個界面擴散。例如在專利申請 US20220359339 中,通過分段式 TIM 設計,有效降低了應力累積和分層風險。
此外,在同一封裝內部采用不同性能的 TIM 材料也成為關鍵策略:高功耗芯片上方配置高導熱 TIM,而外圍區域則采用更厚或更具彈性的材料,以吸收翹曲應變、減緩界面應力。相關思路見于專利 US11088109 及 US20220359339。其核心理念在于,通過空間分區設計,在熱性能與機械可靠性之間實現協同優化,而非簡單權衡。

圖 1:多 TIM 封裝及其形成方法(US20220359339)
復合材料與石墨 TIM:材料與結構協同優化
在高強度熱循環環境下,僅靠單一材料已難以滿足可靠性要求。臺積電在專利 US11107747 中提出復合型 TIM:在高導熱金屬基體中嵌入金屬鍍層聚合物顆粒,在保持導熱性能的同時引入彈性緩沖能力,從而減輕應力集中、改善厚度均勻性并降低芯片開裂風險。
對于石墨基 TIM——雖然具有優異的面內導熱能力,但脆性高、附著性不足——臺積電通過設置間隔框架結構,對石墨層進行機械隔離與壓縮控制,以提升界面穩定性(US20250309071)。
在金屬 TIM 方面,為抑制金屬間化合物增長和 Kirkendall 空洞帶來的長期可靠性問題,臺積電采用晶向工程技術:利用高度織構化的 Cu(111) 擴散阻擋層減少原子互擴散,同時保持良好導熱性能(US20250118615);在無蓋或環形 CoW 架構中,通過直接金屬鍵合方式避免回流焊過程中的再熔風險(US20250349654)。這些技術表明,TIM 的可靠性來源于材料、微結構與界面工程的整體優化。
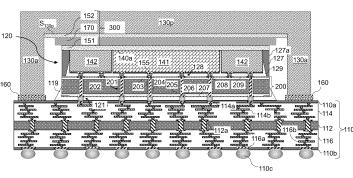
圖 2:包含散熱結構的封裝結構及其形成方法(US20250118615)
2. 重新構建 3DIC 與異構封裝中的熱路徑
在 3D 堆疊封裝中,內部芯片往往被底部填充材料和模封材料包圍,熱量容易滯留,從而形成熱點并加劇層間熱串擾。
針對這一問題,臺積電將 TIM 從傳統的平面界面轉化為三維熱網絡的重要組成部分:
通過高導熱蓋板與精準控制的TIM點膠工藝,建立更直接的垂直散熱路徑(US11482465);
借助多 TIM 分區及定向散熱結構,為高功耗芯片優先構建散熱通道,同時減少對低功耗區域的冗余金屬化(US20240363474);
在芯片或蓋板表面引入微通道或腔體,并填充 TIM,增加接觸面積,從而提升局部熱點散熱效率(CN121096975)。
這些方案的共同特點是:熱界面不再是單一平面,而是根據芯片功耗分布進行定制化設計,形成針對特定芯片的垂直散熱路徑。
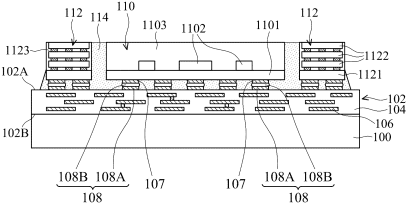
圖 3:具備熱管理特征的半導體芯片封裝形成方法(US20240363474)
臺積電在 3DIC 封裝中的熱管理理念,本質上是一種熱與機械協同工程方法。隨著集成密度提升,熱流密度增加的同時,材料間熱膨脹差異也放大了應力問題,可能引發熱點、翹曲以及“未鍵合”等電氣缺陷,進而影響可靠性。
相關專利展示了多種互補技術手段:
1.具備導熱與應力調節功能的間隙填充結構,用于降低翹曲并改善熱路徑(US12249566);
2.覆蓋芯片的支撐基板結構,同時充當機械加固層與熱傳導通道,并可結合虛擬芯片或材料搭配實現應力平衡(US20250266318);
3.采用減薄載體芯片與對齊虛擬焊盤的頂部散熱架構,使熱量通過前端互連向上傳導(US20250300149)。
同時,臺積電還提出相配套的制造流程優化方案,如載體與去鍵合層設計、受控堆疊與釋放順序等,以提升大規模制造中的對準精度和結構穩定性(US20250167060)。

圖 4:具備散熱結構與翹曲控制的 3DIC(US20250266318)

圖 5:高效散熱的 3DIC 封裝(US20250300149)
熱界面材料在先進封裝中的角色已根本性轉變,成為連接熱性能與機械可靠性的樞紐。從分段式TIM設計釋放局部應力,到復合材料及晶向工程技術抑制界面失效,再到3DIC中定制化垂直散熱網絡的構建,一系列創新專利表明:未來的熱管理不再是單一維度的導熱優化,而是涵蓋材料選擇、微觀結構設計及制造流程的系統性協同工程。






